
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
Принципи и технологија физичког таложења паре (ПВД) премаза (2/2) - ВеТек Семицондуцтор
2024-09-24
Превлака испаравањем електронских зрака
Због неких недостатака отпорног загревања, као што је ниска густина енергије коју обезбеђује отпорни извор испаравања, одређено испаравање самог извора испаравања које утиче на чистоћу филма, итд., потребно је развити нове изворе испаравања. Превлака за испаравање електронским снопом је технологија премаза која ставља материјал за испаравање у водено хлађен лончић, директно користи електронски сноп за загревање филмског материјала и испарава филмски материјал и кондензује га на подлози да би се формирао филм. Извор испаравања електронског зрака може се загрејати на 6000 степени Целзијуса, што може да растопи скоро све уобичајене материјале и може да депонује танке филмове на подлогама као што су метали, оксиди и пластика великом брзином.
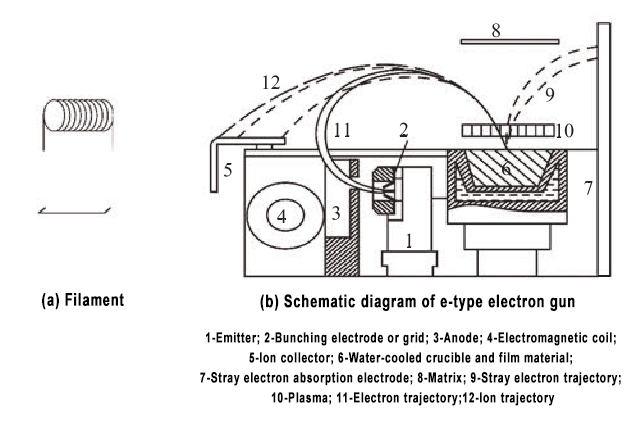
Ласерско пулсно таложење
Пулсно ласерско таложење (ПЛД)је метода за прављење филма која користи високоенергетски импулсни ласерски зрак за озрачивање циљног материјала (масовни циљни материјал или материјал велике густине пресованог од прашкастог филмског материјала), тако да се локални циљни материјал у трену подиже до веома високе температуре и испарава, формирајући танак филм на подлози.
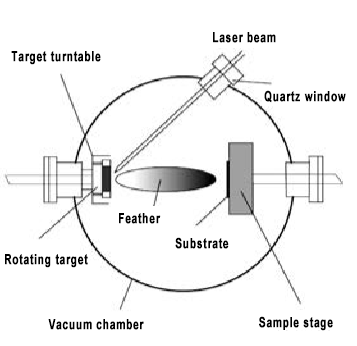
Епитаксија молекуларног зрака
Епитаксија молекуларног зрака (МБЕ) је технологија припреме танког филма која може прецизно контролисати дебљину епитаксијалног филма, допирање танког филма и равност интерфејса на атомској скали. Углавном се користи за припрему танких филмова високе прецизности за полупроводнике као што су ултра танки филмови, вишеслојни квантни бунари и суперрешетке. То је једна од главних технологија припреме за нову генерацију електронских уређаја и оптоелектронских уређаја.
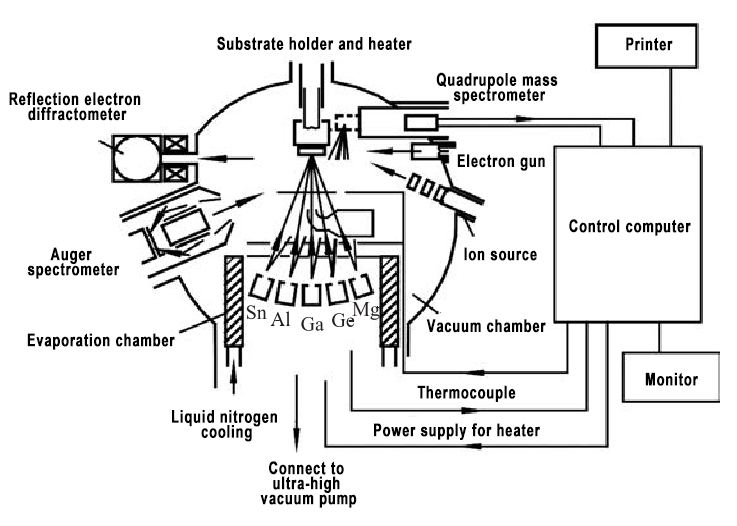
Епитаксија молекуларним снопом је метода премаза која поставља компоненте кристала у различите изворе испаравања, полако загрева филмски материјал у условима ултра-високог вакуума од 1е-8Па, формира проток молекулског снопа и распршује га на подлогу при одређеној термичка брзина кретања и одређена пропорција, узгаја епитаксијалне танке филмове на подлози и прати процес раста на мрежи.
У суштини, то је премаз вакуумског испаравања, укључујући три процеса: генерисање молекуларног снопа, транспорт молекулског снопа и таложење молекуларног снопа. Шематски дијаграм опреме за епитаксију молекуларним снопом је приказан изнад. Циљни материјал се ставља у извор испаравања. Сваки извор испаравања има преграду. Извор испаравања је поравнат са подлогом. Температура загревања подлоге је подесива. Поред тога, постоји уређај за праћење за праћење кристалне структуре танког филма на мрежи.
Вакуумски премаз за прскање
Када се чврста површина бомбардује енергетским честицама, атоми на површини чврстог тела се сударају са енергетским честицама и могуће је добити довољну енергију и импулс и побећи са површине. Ова појава се зове прскање. Распршивање премаза је технологија премаза која бомбардује чврсте мете енергетским честицама, распршујући циљне атоме и таложи их на површину супстрата да би се формирао танак филм.
Увођење магнетног поља на циљну површину катоде може користити електромагнетно поље да ограничи електроне, продужи пут електрона, повећа вероватноћу јонизације атома аргона и постигне стабилно пражњење под ниским притиском. Метода премаза заснована на овом принципу назива се магнетронско распршивање премаза.
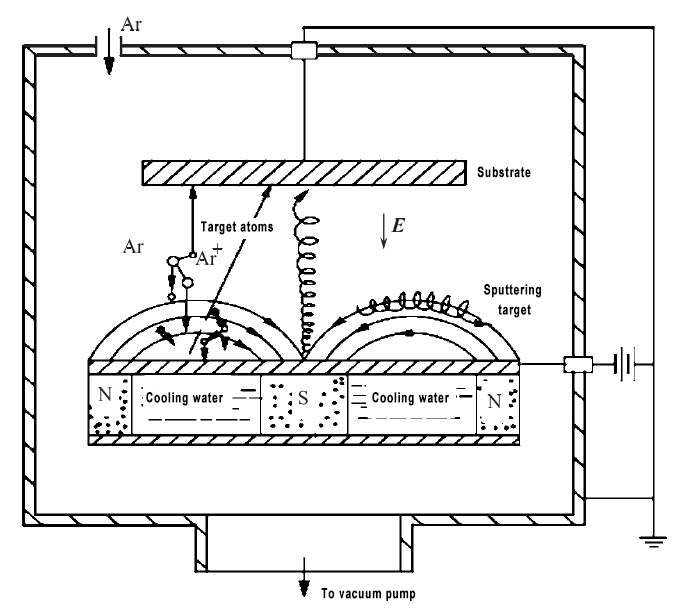
Принцип дијаграмаДЦ магнетронско распршивањеје као што је приказано изнад. Главне компоненте у вакуумској комори су мета магнетронског распршивања и супстрат. Подлога и мета су окренути један према другом, подлога је уземљена, а мета је повезана на негативни напон, односно подлога има позитиван потенцијал у односу на мету, па је смер електричног поља од подлоге. до циља. Трајни магнет који се користи за генерисање магнетног поља постављен је на полеђини мете, а магнетне линије силе усмеравају од Н пола трајног магнета до С пола и формирају затворени простор са површином катоде.
Мета и магнет се хладе расхладном водом. Када се вакуумска комора евакуише на мање од 1е-3Па, Ар се пуни у вакуумску комору до 0,1 до 1Па, а затим се напон примењује на позитивни и негативни пол да би се гасно пражњење усијало и формирала плазма. Јони аргона у аргонској плазми се крећу ка катодној мети под дејством силе електричног поља, убрзавају се при проласку кроз тамно подручје катоде, бомбардују мету и избацују циљне атоме и секундарне електроне.
У процесу облагања ДЦ распршивањем, неки реактивни гасови се често уводе, као што су кисеоник, азот, метан или водоник сулфид, флуороводоник, итд. Ови реактивни гасови се додају у аргон плазму и побуђују, јонизују или јонизују заједно са Ар. атома да формирају различите активне групе. Ове активиране групе достижу површину супстрата заједно са циљним атомима, пролазе кроз хемијске реакције и формирају одговарајуће филмове једињења, као што су оксиди, нитриди, итд. Овај процес се назива ДЦ реактивно магнетронско распршивање.
ВеТек Семицондуцтор је професионални кинески произвођачТантал-карбид премаз, Премаз од силицијум карбида, Специјални графит, Керамика од силицијум карбидаиДруга полупроводничка керамика. ВеТек Семицондуцтор је посвећен пружању напредних решења за различите премазе за индустрију полупроводника.
Ако имате било каквих питања или су вам потребни додатни детаљи, не устручавајте се да нас контактирате.
Моб/ВхатсАПП: +86-180 6922 0752
Е-пошта: анни@ветексеми.цом



